高密度プラズマスパッタリング装置
基板ダメージが少ない/イオン量とエネルギーを独立制御/磁性体ターゲットに使用可能
概要
デバイスの微細化の進展または薄膜結晶の高品質化の要求が高まるにつれて、スパッタリングにおいて基板へのイオンダメージが大きな問題となっている。従来広く利用されているマグネトロンスパッタ法では、ターゲット材と基板の間に直接プラズマを形成するため、「①イオンダメージの回避が困難」であり、高密度プラズマ生成時にはこの問題が顕著化してしまう。またプラズマ生成のための放電とイオン引き込みを同一の電源で同時に行うため、「②ターゲット材へ流入するイオン量とそのエネルギーを独立に制御することが不可能」であること。ターゲット表面に存在する漏れ磁束でプラズマ閉じ込めを行うため、「③磁性体ターゲットにおいては使用が困難である」ことなどの課題も存在する。
本発明は、ヘリコン放電による高密度プラズマ生成や、湾曲磁場によるプラズマ形状制御等により、上記①~③の課題を解決するものであり、それと同時にターゲット材の昇温機構を兼ねることや、大口径基板への均一成膜、高速成膜も検討し得る。
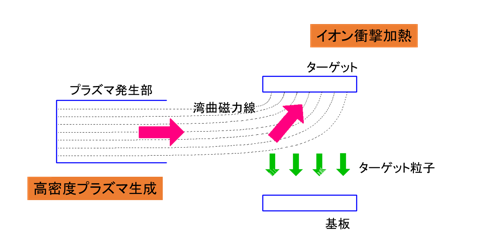
性能・特徴等
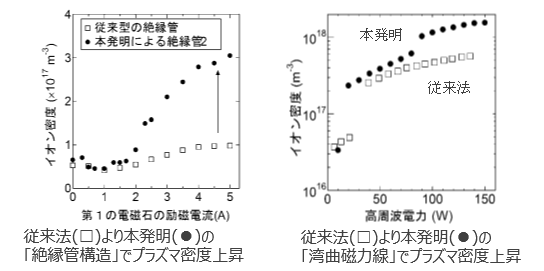
応用例
・基板へのダメージを抑制した高品質結晶薄膜形成
・厚みのある磁性体をターゲットとした成膜
・ターゲット材料の蒸発及び昇華現象を重畳した成膜
・大口径ターゲット及び基板への均一な成膜
関連文献
[1] T. Saito, K. Takahashi, et al., Vacuum, 163, 269 (2019).
[2] K. Takahashi et al., Vacuum, 171, 109000 (2020).
[3] 高橋和貴,革新的半導体産業システム”ミニマルファブ”におけるプラズマテクノロジー -ヘリコン波プラズマ源を用いたマルチターゲットスパッタリング装置-, J. Plasma Fusion Res. 10, 522 (2020).
知的財産データ
知財関連番号 : 特開WO2018-143164(JP)、登録10854448号(US)
発明者 : 髙橋 和貴、福島 潤、安藤 晃、佐々木 保正
技術キーワード: 制御、計測、機械
